蚀刻工艺简介:
刻蚀工艺是利用化学的、物理的或同时使用化学和物理的方法,有选择地把无掩蔽的那一部分薄膜层除去,从而得到所需的微结构。 刻蚀分为干法刻蚀和湿法腐蚀。干法刻蚀主要利用反应气体与等离子体进行刻蚀;湿法腐蚀主要利用化学试剂与被刻蚀材料发生化学反应进行刻蚀。需根据加工要求选择合适的刻蚀方法和参数。
1、国产电感耦合等离子体刻蚀机
设备简介:
由中国科学院微电子中心研制的电感耦合等离子体刻蚀机可以刻蚀Si、SiO2及SiNx。工作气体包括SF6和CHF3,采用独立流量控制,通过转换装置可实现2种工作气体单独进气、交替进气或混合进气。样品台可放置单片或多片样品,也可放置形状不规则的样品。
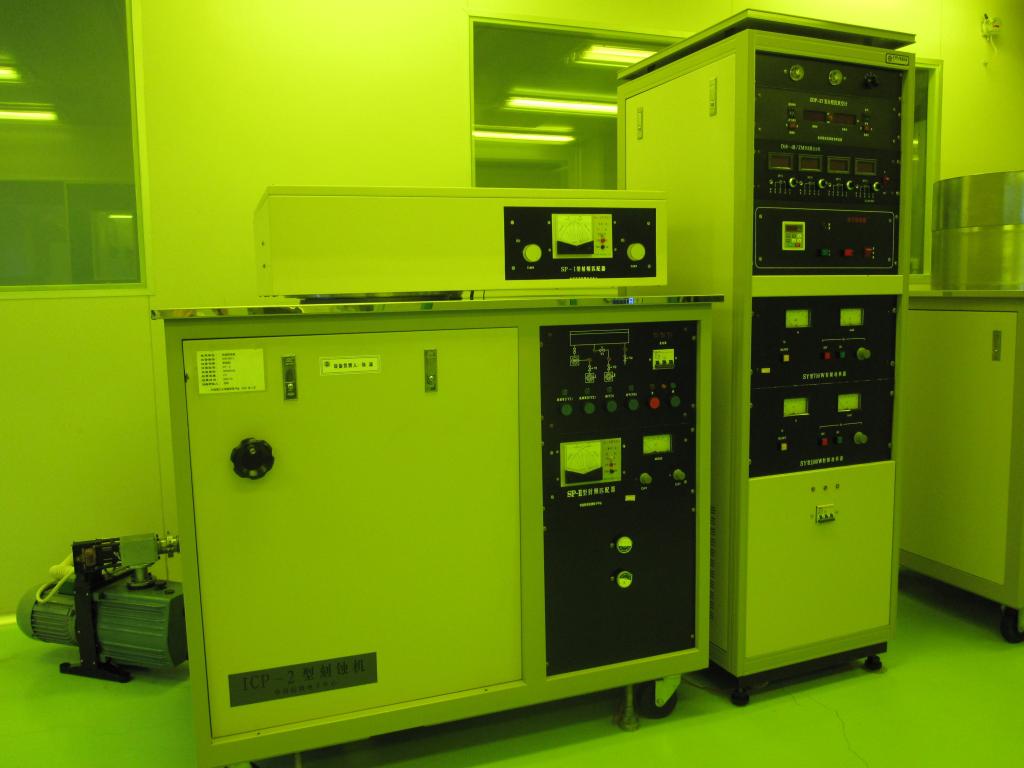
主要参数:
样品规格:最大5英寸;极限真空度:4×10-4Pa;真空室规格:直径300mm,高度280mm
2、进口电感耦合等离子体刻蚀机
设备简介:
法国Alcatel公司的电感耦合等离子体刻蚀机采用专业智能化界面操作并监控设备运行过程。设备配置SF6、C4F8、O2共计3路工作气体,3路气体可以各自独立进气,也可以2路气体交替进气,可以刻蚀Si、SiO2及SiNx。在刻蚀Si工艺中可以实现高刻蚀速率、高深宽比刻蚀等,均匀性、选择性较好,各向异性程度高。

主要参数:
刻蚀Si: 刻蚀速率=5-10μm/min
刻蚀均匀性<± 8%(4英寸硅片)
侧壁角度90o ± 2o
刻蚀SiO2:刻蚀速率>0.3μm/min
刻蚀均匀性<± 5%(4英寸硅片)
掩膜选择比>1:1

